QR code

Products
Nobis loquere


Fax
+86-579-87223657

E-mail

Oratio
Wangda Road, Ziyang Street, Wuyi Comitatus, Jinhua urbs, Zhejiang Provincia, China
EtchingTechnology est unus ex key gradus in semiconductor vestibulum processus, quae est ad removendum propria materiae ex lagam ad formare circuitus exemplar. Tamen, in arida etching processus, engineers saepe occurrant problems ut loading effectus, micro-sulcus effectum et præcipiens effectus, quod directe afficit qualis et perficientur finalis.
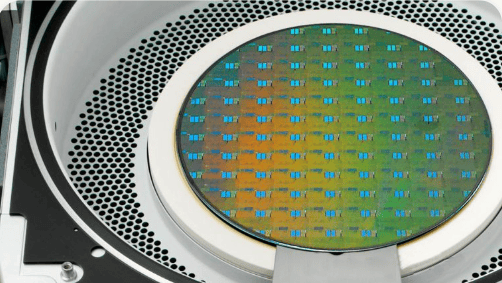
Loading effectus refers to the phaenomenon, quod cum etching area crescit vel etching profundum crescit in sicco etching, etching rate decrescit vel etching est inaequaliter debitum ad satis copia reactive plasma. Hunc modum solet ad characteres de Etching ratio, ut plasma density et uniformitatem, vacuo gradu, etc, et late in variis reactive Ion ethuca.
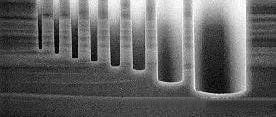
•Improve plasma densitatis et uniformitatisPer optimizing consilio plasma fonte, ut usura magis efficiens RF potestas vel Magnetron spundlying technology, altiorem densitatem et magis uniformiter distributed plasma potest generari.
•Adjust compositionem de reactive Gas: Addit convenientem moles auxiliaris Gas ad reactivum Gas potest amplio in uniformitatem plasma et promovere effective missionem etching byproducts.
•Optimize in vacuo ratio: augere flare celeritatem et efficientiam sentinae vacui adiuvare potest reducere residentiae tempus etching byproductorum in cubiculo, inde oneris effectum minuendo.
•Rationabile photolithographiae layout: Cum designing Photolithography layout, densitas exemplar debet esse in rationem vitare super-densa Ordinatio in loci areas ad redigendum impulsum de onus effectus.
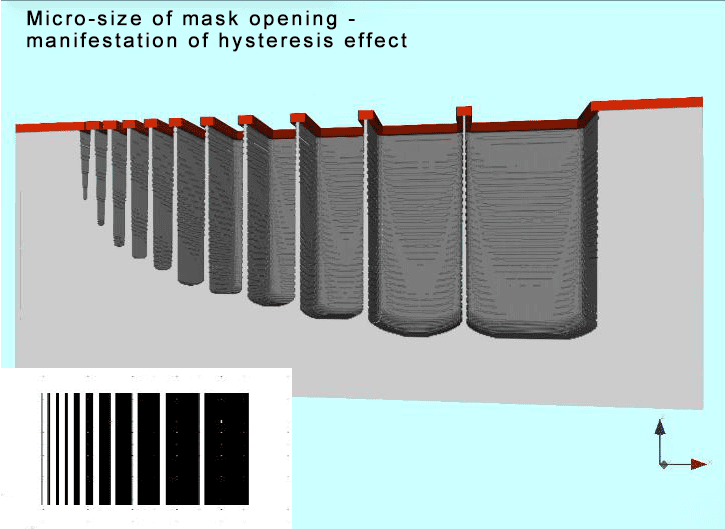
Et Micro-tranching effectum refers to the phaenomenon quod per etching processus, debitum ad summus industria particulas premendo etching superficiem ad inclinavit angulus, etching rate prope latus murum est altior quam in centralis area, unde non -verticals chamfers latus murum. Phaenomenon est propinqua angulo incident particulas et clivo lateris parietem.
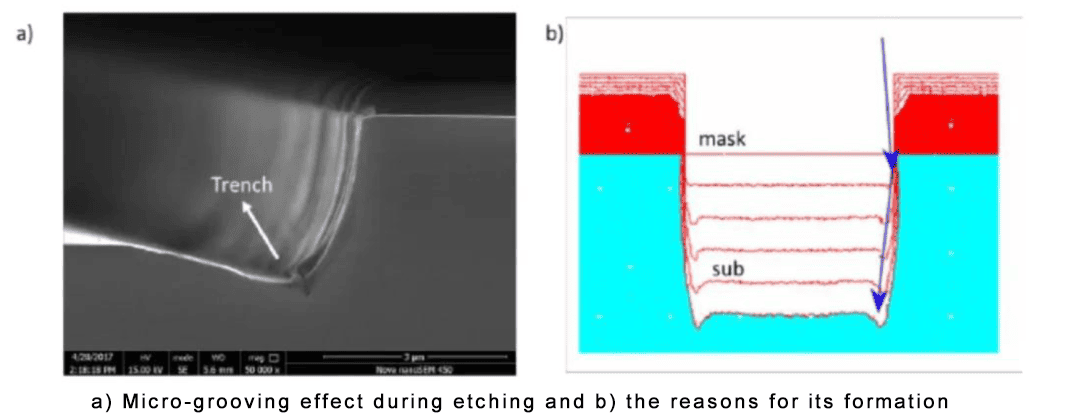
•Crescere RF Power: Proprie augendae ad RF potestas potest crescere industria de incident particulas, permittens eos ad bombard in scopum superficiem plus perpendiculariter, ita reducendo etching rate difference lateri.
•Elige ius etching larva materiales: Quidam materiae potest melius resistere præcipiens effectus et reducere micro-tranching effectum aggravatur per cumulus negative causam in persona.
•Optimize Etching Conditions: parametris subtiliter adaptatis sicut temperatura et pressionis in processu escificatione, selectivity et uniformitas escificationis efficaciter regi possunt.
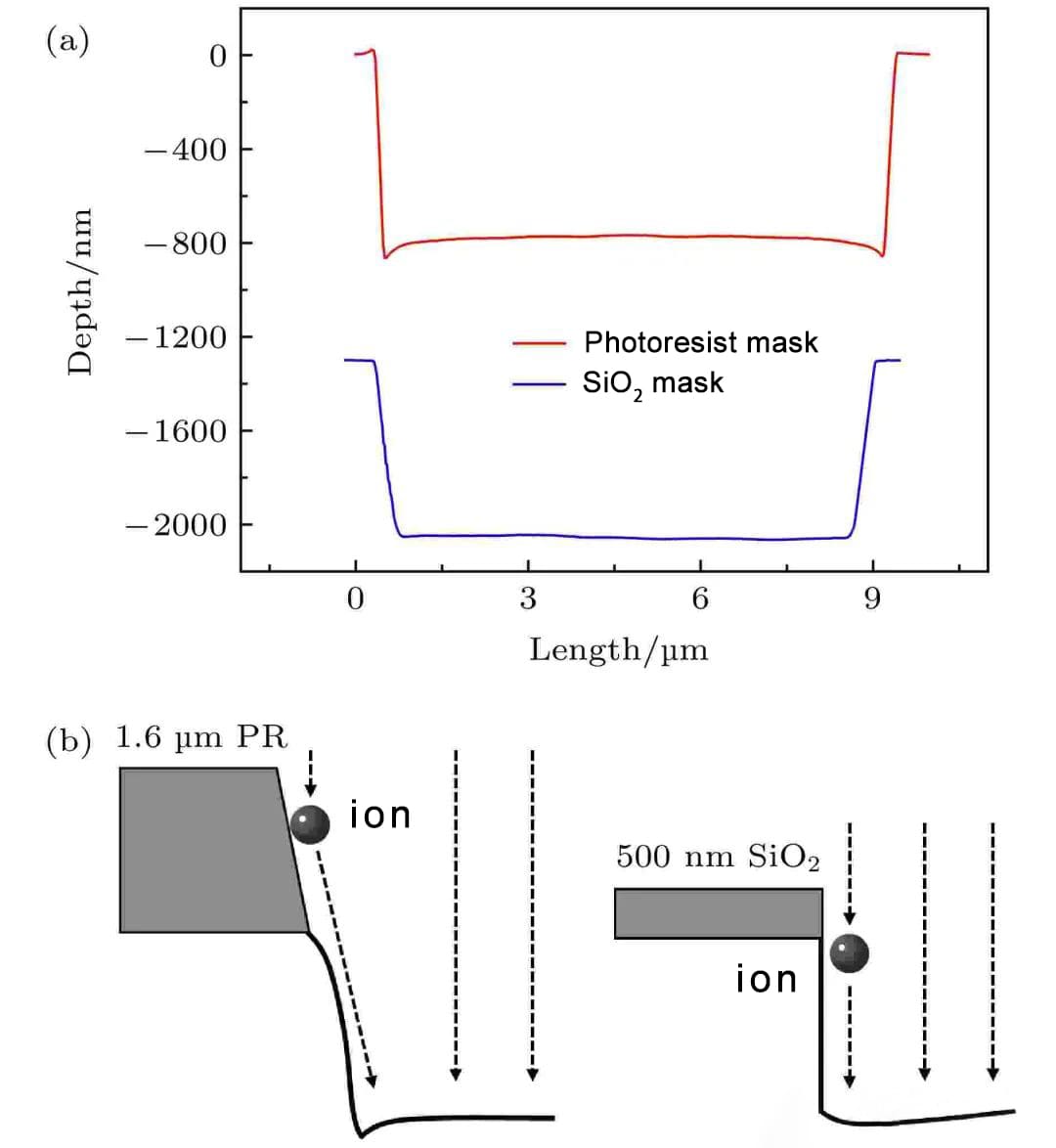
Prćcipiens effectus causatur per insulating proprietates etching larva. Cum electrons in plasma potest evadere cito, colligent in persona superficiem ad formare loci electrica agro, intermixti semita incident particularum, et afficiunt anisotropy etching, praesertim cum afficiunt anisotropy etching, praesertim cum etching etc etching, praesertim cum etching in anisotropy structuras, praesertim cum etching etcucus.
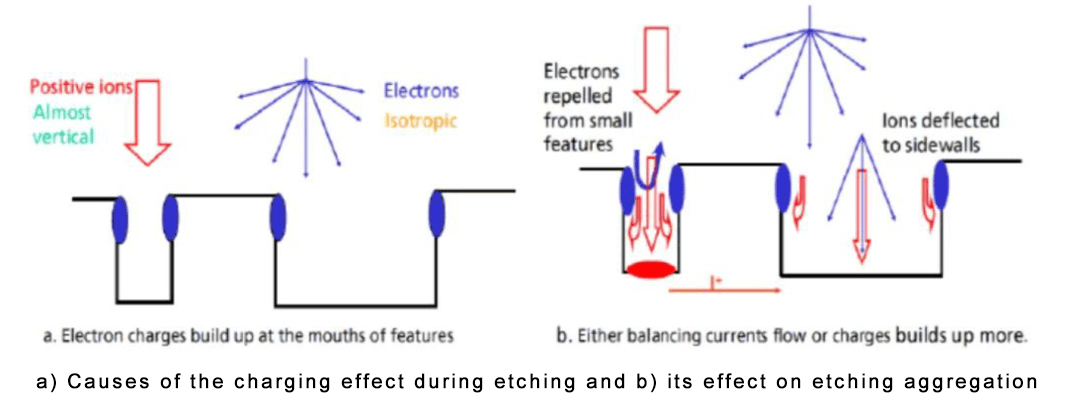
• Eligere idoneam etching persona materiae: Quidam specialiter tractata materiae vel PROLIXUS larva laminis potest efficaciter reducere aggregationem electrons.
•Effectum deducendi intermittentium etching: Per intervalla interrumpente processum et schismaticum et electronicos satis temporis ad effugium dando, signanter effectus praecipiens minui potest.
•Adjust engraving amet: Mutantur ad Gas compositionem, pressura et aliis conditionibus in Etching elit potest auxilium amplio stabilitatem plasma et reducere ad eventum prćcipiens effectus.
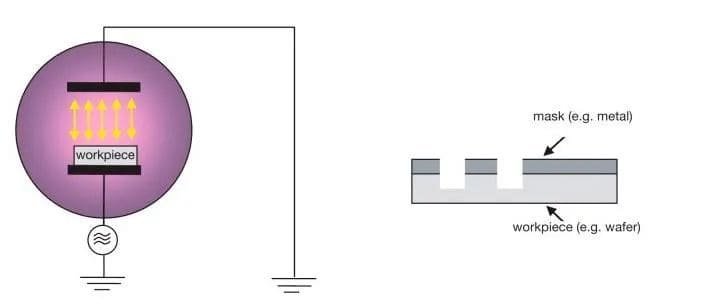



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi Comitatus, Jinhua urbs, Zhejiang Provincia, China
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. All Rights Reserved.
Links | Sitemap | RSS | XML | Privacy Policy |
