QR code

Products
Nobis loquere


Fax
+86-579-87223657

E-mail

Oratio
Wangda Road, Ziyang Street, Wuyi Comitatus, Jinhua urbs, Zhejiang Provincia, China
In ostensionibus semiconductoribus et FPD tabulis, praeparatio membranarum tenuium processus magni momenti est. Sunt multi modi parare tenues films (TF, tenuis film), in sequentibus duo modi sunt communia:
● CVD (eget vapor depositione)
● PVD (physica vapor depositione)
Inter eos, iacuit quiddam/activum/insulationis stratum/omnia in cubiculi machinae utentis PECVD repositae sunt.
● Utere gasis specialibus: SiH4/NH3/N2O ad depositionem Sin et Si/SiO2 cinematographicis.
● Quidam CVD machinis postulo utor H2 ad Hydrogenation ad augendam carrier mobilitatem.
NF3 purgatio gas est. Prae: F2 valde toxicus, et effectus CONSERVATORIUM SF6 altior quam NF3 est.
In processu fabricae semiconductore plura genera membranarum tenuium sunt, praeter communem SiO2/Si/SiN, adsunt etiam W, Ti/TiN, HfO2, SiC, etc.
Hoc quoque causa est cur plures species praecursatorum provecta materiae in semiconductor industria, ut facere varias tenuis films.
I. Genera CVD et quidam precursor gasorum
2. Basica machina CVD et cinematographica
CVD conceptus generalissimus est et in multas species dividi potest. Communis sunt:
● Pecvd: Plasma Consectetur CVD
LPCVD: Minimum Pressura CVD
ALD: Depositio atomi Layer
● Mocvd: Metal-organicum CVD
In processu CVD, vincula praecursoris chemica ante reactiones chemicas frangi necesse est.
Et industria pro fractionis chemical vincula est a calore, sic thalamum temperatus erit relative altum, quod non est amica ad aliquos processiones, ut subiectum est speculum de panel vel pi materiale in screen. Ideo per inputting alia industria (formatam plasma, etc.) ad redigendum processus temperatus obviam aliquos processiones quod requirit temperatus, thermal budget etiam reduci.
Ergo PECVD depositio a-Si:H/SiN/poly-Si late in FPD industria ostentationis adhibita est. Communia CVD praecursores et membranae:
Polycrystallini silicon/SiO2 SIN/SiON W/Ti WSi2 HfO2/SiC cristallinus singularis.
Gradus fundamentales mechanismi CVD:
I. reactionem praecursor Gas intrat in camera
2. media producta per Gas reactionem
3. Intermedia producta gasi ad superficiem subiectam diffundunt
IV. ADSORBED in subiecto superficies et diffusa
5. Reactio chemica occurrit in superficie subiecta, formatio nucleatio/insula/formatio cinematographica
VI. Byproducts sunt Desorbed, vacuo exantlaretur et dimitti post intrantes scrubber ad curatio
Ut antea, totum processus includit multiplex gradus ut diffusio / adsorption / reactionem. In altiore film formation rate est affectus multis factoribus, ut temperatus / pressura / genus reaction Gas / genus subiecti. Diffusioni exemplum diffusionis habet praedictionis, adsorptio adsorptionem theoriam habet, et reactionem chemica motus theoriae motus habet.
Totum processum, tardissimus gressus totam rate reactionem determinat. Hoc simillimum est methodi criticae in administratione rei publicae. Longissima actio fluens determinat durationem brevissimam. Diuturnitas minui potest ab opibus collocandis ad tempus huius itineris minuendum. Similiter CVD invenire key bottleneck quod fines amet formation rate per intellegendum totius processus, et adjust in parametri occasus ad consequi idealis film formation rate.
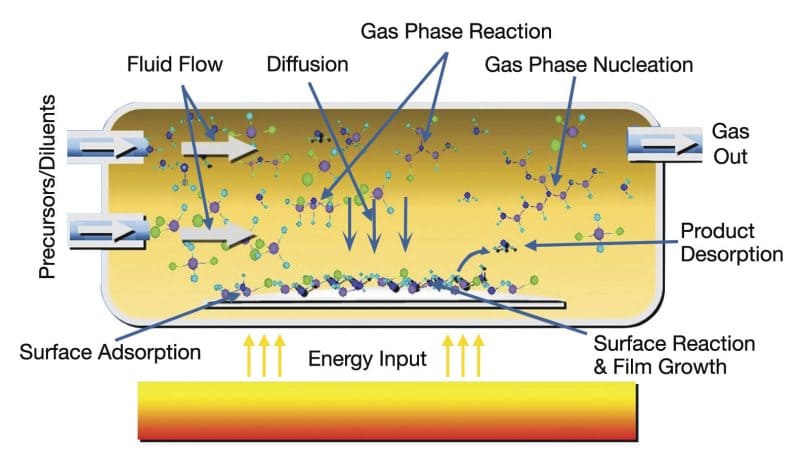
Quidam films sunt plana, quidam sunt foraminis implere, et sulcus saturabuntur, cum diversis munera. Commercial CVD machinis postulata postulata conveniant;
● apparatus processus capacitatem, depositionem rate
● constanty
● Gas tempus reactiones non producendum particulas. Est ipsum momenti non producere particulas in Gas tempus.
Quidam alias iudicium requisita sunt, ut sequitur:
● bonum gradus coverage
capacitas ad imple summo aspectu ratio hiatus (conformality)
bonum crassitudine uniformitas
● Puritas et density
● High gradu structural perfectum cum humilis film accentus
Bene electrica proprietatibus
● Praeclara adhaesio materiae subiectae



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi Comitatus, Jinhua urbs, Zhejiang Provincia, China
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. All Rights Reserved.
Links | Sitemap | RSS | XML | Privacy Policy |
